ページ番号:143176
掲載日:2025年7月9日
ここから本文です。
集束イオンビーム加工観察装置による試験
| 大分類/中分類 | 材料試験/組織試験 |
|---|---|
| 試験の内容 |
試験内容電子ビームとGaイオンビームのダブルビームを備えた装置で実施する試験です。 目的の微小部について、Gaイオンビーム照射で観察・断面作成し、作成した断面をSEMで観察します。 ※30,000倍を超える倍率のSEM観察は、走査型電子顕微鏡による高分解能試験となるため別料金が必要です。 ※SEM-EDX分析は、分析走査電子顕微鏡(SEM-EDX)による分析 定性分析となるため別料金が必要です。 主な測定試料薄層、微小な不具合箇所などのような、機械研磨での断面作成が難しいサンプル 金属、非金属、電子基板、ガラス基板、メッキ製品 キーワードFIB、複合ビーム加工観察、メッキの不具合解析、位置を特定した精密断面観察 |
| 成績書の内容 | 写真 成績書例(PDF:205KB) 参考資料例(PDF:66KB) |
| 試料持込時の注意 |
顕微鏡に導入可能なサイズはφ25mm(径)×20mm(高さ)程度です。 大きさ・材質によっては事前に切断をお願いする場合がありますので、切断する前にまず担当者と相談してください。 |
| その他の注意 | 別途、試験片調製の料金をいただく場合があります。詳しくは担当者と相談してください。 |
| 単位 | 1ヶ所 10μm×10μm以内 |
| 金額 | 28,300円 (1ヶ所(10μm×10μm以内)増すごとに17,000円を加える。) |
| 装置外観等 | 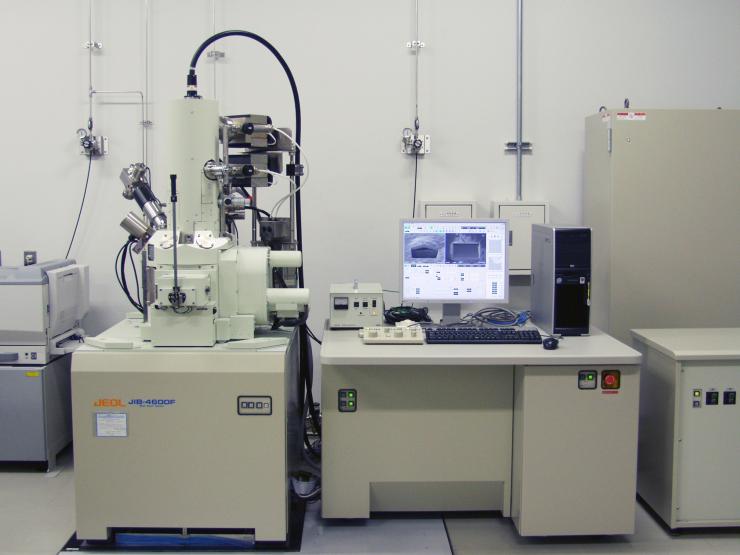 |
| 測定事例 |
金メッキ品の観察事例を紹介いたします。
左:二次電子像 右:反射電子像 いずれも観察倍率は5000倍
左:二次電子像 右:反射電子像 いずれも観察倍率は30000倍
|
| 備考 |
使用装置の主な仕様は下記のとおりです。 倍率:×30~×300,000(FIB)、×20~×1,000,000(SEM) |
|
本試験に関する お問合せ先 |
048-265-1369(材料技術・事業化支援室 材料技術担当) |
より良いウェブサイトにするためにみなさまのご意見をお聞かせください